CUBE as the Solution
CUBE addresses the shortcomings of conventional memory IC and module solutions through novel approaches to increasing I/O count and raising data speed, support for Through-Silicon Via (TSV) technology as an option, and its 3D architecture that reduces thermal dissipation issues.
As an innovative, patented high-bandwidth memory interface technology, CUBE enables memory modules to be optimized for seamless performance when running AIs that use large model sizes, whose demands outstrip the bandwidth available with conventional memory modules. While enhancing bandwidth, CUBE also reduces power consumption.
CUBE enhances the performance of front-end 3D structures such as chip on wafer (CoW) and wafer on wafer (WoW), as well as back-end 2.5D/3D chip on Si-interposer on substrate and Fan-out solutions. On the other hand, CUBE is easily adopted in new product designs. While CUBE suitable for use with power-conscious high-bandwidth edge/endpoint AI devices that combine the strengths of cloud and edge engines. These are expected to be the next phase in making advanced AI applications more accessible, overcoming security and cost issues.
Suitable for power-conscious design, CUBE enables seamless and efficient deployment of AI models across different platforms and use cases, including edge devices, surveillance.
CUBE in Detail
Found in current offerings, thereby enhancing overall system performance.
Also, CUBE benefits from outstanding power efficiency, consuming less than 1pJ/bit. This makes it particularly well-suited for energy-sensitive applications, outperforming less power efficient alternatives.
Moreover, the compact form factor, achieved through 3D stacking options and a small size, makes CUBE an ideal choice for portable and space-constrained devices. The innovative 3D architecture of CUBE strategically places the System on Chip (SoC) on the top die close to the heatsink, effectively mitigating heat dissipation concerns associated with AI computing.
Another key feature is CUBE's flexibility in design, allowing for customization to meet the specific requirements of various applications and so provide tailored solutions for customers. The integration of Through-Silicon Vias (TSVs) in CUBE contributes to improved power delivery, signal integrity, and overall system efficiency.
CUBE's flexible design allows customization of die area, optimized according to specific customer SoC specifications.
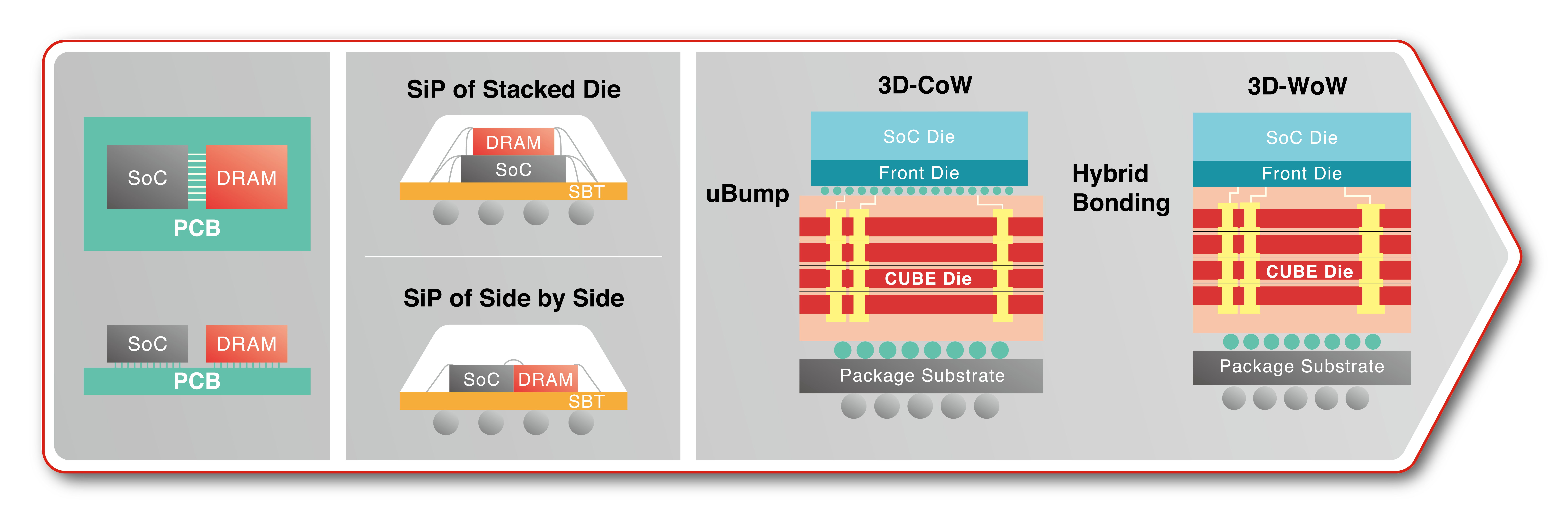
Winbond is actively engaging with partner companies to establish the 3DCaaS platform, which will leverage CUBE's capabilities. By integrating CUBE with existing technologies, Winbond aims to offer cutting-edge solutions that empower businesses to thrive in the era of AI-driven transformation. For any related inquiries or requirements, please contact us via Technical support.



 English
English






